第九屆晶芯研討會(huì)成功舉辦,聚焦新時(shí)代先進(jìn)封裝技術(shù)發(fā)展與應(yīng)用
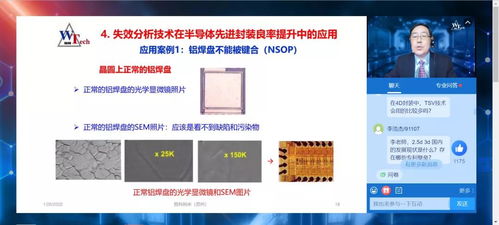
2023年10月,第九屆晶芯研討會(huì)在北京國家會(huì)議中心圓滿閉幕。本屆研討會(huì)以“新時(shí)代先進(jìn)封裝技術(shù)發(fā)展和應(yīng)用”為主題,吸引了來自全球頂尖的計(jì)算機(jī)軟硬件技術(shù)開發(fā)領(lǐng)域的專家、學(xué)者及企業(yè)代表共襄盛舉。
在開幕式上,中國半導(dǎo)體行業(yè)協(xié)會(huì)副會(huì)長王明致歡迎辭。他指出,隨著人工智能、物聯(lián)網(wǎng)和高性能計(jì)算的迅猛發(fā)展,先進(jìn)封裝技術(shù)已成為推動(dòng)芯片性能提升和系統(tǒng)集成優(yōu)化的關(guān)鍵驅(qū)動(dòng)力。晶芯研討會(huì)作為行業(yè)交流的重要平臺(tái),旨在促進(jìn)技術(shù)創(chuàng)新與產(chǎn)業(yè)鏈協(xié)同發(fā)展。
本屆研討會(huì)設(shè)置了多個(gè)專題分論壇,涵蓋先進(jìn)封裝材料、3D集成技術(shù)、異構(gòu)集成、封裝測(cè)試與可靠性等熱點(diǎn)議題。來自英特爾、臺(tái)積電、中科院微電子所等機(jī)構(gòu)的專家分享了最新研究成果。例如,英特爾展示了其基于Foveros技術(shù)的3D堆疊方案,可實(shí)現(xiàn)更高能效和更小尺寸的芯片設(shè)計(jì);臺(tái)積電則介紹了其在CoWoS(晶圓級(jí)封裝)領(lǐng)域的突破,助力高性能計(jì)算和人工智能應(yīng)用。
在計(jì)算機(jī)軟硬件技術(shù)開發(fā)環(huán)節(jié),多位資深工程師探討了封裝技術(shù)與系統(tǒng)設(shè)計(jì)的深度融合。華為海思的代表強(qiáng)調(diào)了先進(jìn)封裝對(duì)5G和邊緣計(jì)算設(shè)備的重要性,通過優(yōu)化封裝結(jié)構(gòu),顯著提升了處理器的散熱性能和信號(hào)完整性。開源硬件社區(qū)的代表也分享了基于RISC-V架構(gòu)的封裝解決方案,推動(dòng)軟硬件協(xié)同創(chuàng)新。
研討會(huì)還設(shè)置了圓桌討論環(huán)節(jié),與會(huì)者就“未來封裝技術(shù)趨勢(shì)與挑戰(zhàn)”展開深入交流。大家一致認(rèn)為,隨著摩爾定律放緩,先進(jìn)封裝將成為延續(xù)半導(dǎo)體產(chǎn)業(yè)發(fā)展的重要路徑,但同時(shí)也面臨成本控制、標(biāo)準(zhǔn)化和生態(tài)建設(shè)等挑戰(zhàn)。專家呼吁加強(qiáng)產(chǎn)學(xué)研合作,加速技術(shù)落地。
此次研討會(huì)不僅展示了先進(jìn)封裝技術(shù)的最新進(jìn)展,還促進(jìn)了行業(yè)內(nèi)的知識(shí)共享與合作。參會(huì)者紛紛表示,晶芯研討會(huì)為計(jì)算機(jī)軟硬件技術(shù)開發(fā)提供了寶貴的靈感與方向,期待下一屆活動(dòng)帶來更多創(chuàng)新成果。
如若轉(zhuǎn)載,請(qǐng)注明出處:http://m.lylyw.cn/product/6.html
更新時(shí)間:2026-03-01 10:07:39